Die elektronischen Eigenschaften von Solarzellen werden in hohem Maße durch dünne Passivierungs- und Kontaktschichten sowie deren Grenzflächen untereinander und zu den lichtabsorbierenden Bereichen beeinflusst. Wir bieten hochaufgelöste und hochsensitive Schichtanalytik an Solarzellen sowie anderen Komponenten von PV-Modulen. So können die Beziehungen zwischen Prozessvariationen und Schichtzusammensetzungen an Passivierungsschichtstapeln auf Solarzellen zurückverfolgt und Schichtdicken auf der Nanometerskala vermessen werden. Zudem verfügen wir über Möglichkeiten, Ursachen für spezifische Moduldefekte nach Lokalisierung mit elektro-optischen Methoden anschließend mittels Elektronenmikroskopie (REM, FIB, TEM mit EBIC, EDX) bis auf die atomare Ebene zurückzuführen, was oftmals erst die Grundlage für das Verständnis und die Beseitigung von Defektursachen darstellt.
Diagnostik Solarzellen
Leistungen
- Hochauflösende Struktur- und Elementanalytik im Schichtstapel: Quantitative Oberflächen- und Tiefenprofilanalysen mit ToF-SIMS, XPS, TEM
- Defektdiagnostik in der Dünnschicht-PV: Lokalisierung, Zielpräparation und Mikrostrukturanalyse
- Herstellung (Magnetron-Sputtern) und Charakterisierung funktioneller Dünnschichten
- Spannungs-Degradationstests und Hochspannungs-Leckstromprüfungen
Beispiele
Hochauflösende Schichtcharakterisierung
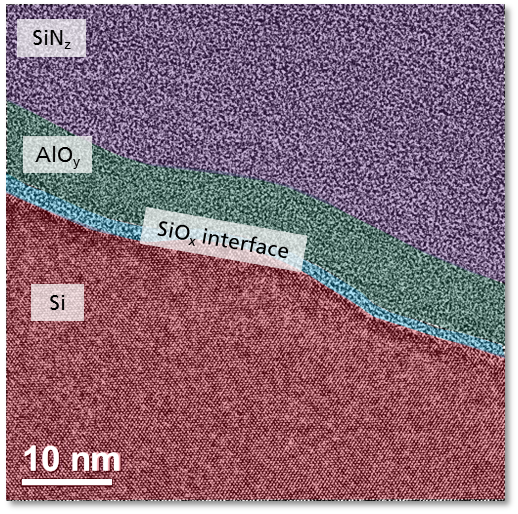
Hochauflösende Schichtcharakterisierung
In aktuellen Zellenkonzepten kommen auf Vorder- und Rückseite der Solarzellen dünne Schichten zum Einsatz, die der Passivierung der Absorberschichten, aber auch Kontaktierung und Ladungsträgertransport dienen. Grundlegende Eigenschaften der Schichtsysteme wie Elementzusammensetzung und Schichtdicken haben dabei einen großen Einfluss auf elektronischen Eigenschaften der Solarzellen. Da die Schichten oft Dicken im Bereich weniger bis einiger 10 Nanometer haben und zudem die Oberflächen oftmals texturiert sind, werden hochauflösende Elektronenmikroskopieverfahren benötigt, um Schichteigenschaften mit Nanometer-Genauigkeit untersuchen zu können. Bei uns kommen Transmissionselektronenmikroskopie (TEM) in Kombination mit energiedispersiver Röntgenspektroskopie (EDX), Elektronenengerie-Verlustspektroskopie (EELS) und Elektronenbeugung (SAED) zum Einsatz, um die nur 50 bis 100 Nanometer dicken Querschnittslamellen, die zuvor aus den Proben präpariert werden, zu analysieren. Komplementär dazu werden Erkenntnisse über eventuelle Verunreinigungen auf den Oberflächen oder in den Schichten anhand von Tiefenprofilen mittels Röntgen-Photoelektronenspektroskopie (XPS) sowie mit höchster Nachweisempfindlichkeit mittels Flugzeit-Sekundärionenmassenspektrometrie (ToF-SIMS) gewonnen.
Beschleunigte PID-Tests


PID-Testgeräte für unverkapselte Solarzellen und installierte Solarmodule
Für die Bewertung von unverkapselten Solarzellen sowie von Modul-Verkapselungsmaterialien hinsichtlich ihrer Anfälligkeit für Potential-induzierte Degradation (PID) wurde am Fraunhofer CSP ein integriertes Testgerät entwickelt. Das patentierte Testverfahren ist als PID-Zellentestgerät „PIDcon“ von Freiberg Instruments kommerziell erhältlich. Mit PIDcon ist es möglich, innerhalb weniger Stunden und ohne den aufwändigen Einsatz teurer Klimakammern PID-Tests an Solarzellen durchzuführen.
Basierend auf dem Know-how wurde gemeinsam mit Freiberg Instruments auch das PID-Modul-Testgerät „PIDcheck“ für den Einsatz im Freifeld entwickelt. Mit PIDcheck wird es möglich, Module auch nach ihrer Installation im Freifeld einer Qualitätsprüfung zu unterziehen und Aussagen über die Anfälligkeit von Modulen für den PID-Effekt zu treffen. Mit vier bis acht Stunden nimmt der Einsatz des Geräts deutlich weniger Zeit in Anspruch als bisherige Methoden.
Schichtdiagnostik
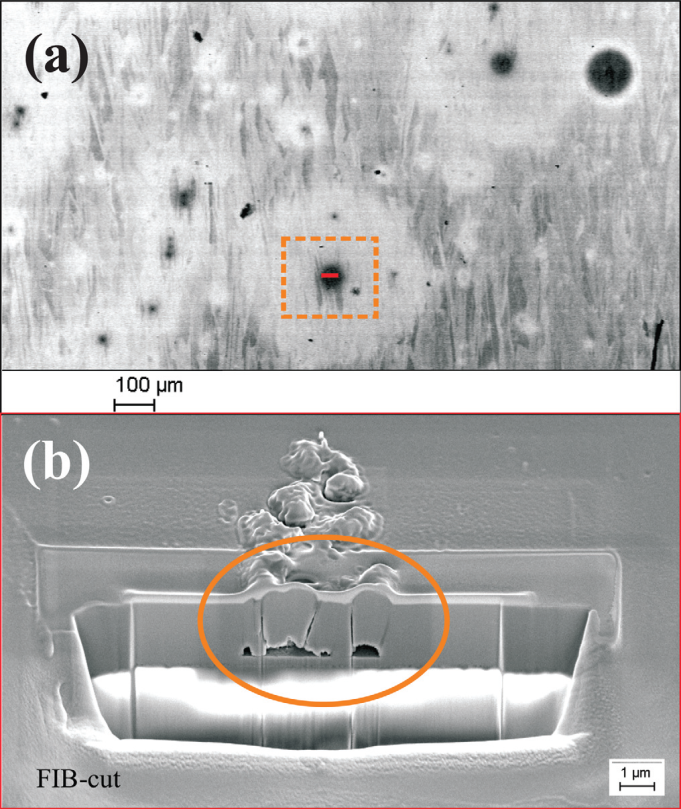
Schichtdiagnostik in der Dünnschicht-PV
Defekte und Verunreinigungen in Dünnschicht-Solarzellen werden mit elektrooptischen Verfahren und REM/EBIC (a) lokalisiert. Durch Zielpräparationsverfahren lassen sich vergrabene Defekte im Schichtaufbau auffinden (b), die Rückschlüsse auf Fehler im Prozess erlauben. Weiterführende elementanalytische Verfahren wie ToF-SIMS, XPS, TEM/EDX helfen bei der Klassifizierung von verschiedenen Defekttypen.
 Fraunhofer-Center für Silizium-Photovoltaik CSP
Fraunhofer-Center für Silizium-Photovoltaik CSP